在半導體封裝領域,銅-金(Cu-Au)引線鍵合系統因其成本優勢與良好的冶金相容性,正逐步替代傳統金-金系統。然而,異種金屬界面長期可靠性仍是亟待解決的行業痛點。本文科準測控小編將從力學檢測視角,為您系統闡述Cu-Au鍵合界面失效機理與定量評估方法。
一、失效根源:Kirkendall空洞
根據Cu-Au二元相圖,該體系會形成Cu?Au、AuCu和Au?Cu三種韌性金屬間化合物,其形成活化能為0.8~1.0 eV。可靠性問題的核心在于異種金屬擴散速率差異所引發的Kirkendall空洞效應,具體表現為Cu原子向Au側擴散速率顯著高于Au原子向Cu側擴散速率,導致Cu側出現空位聚集,并逐漸發展為微觀空洞。空洞的形成直接減少鍵合界面的實際承載面積。

Cu-Au二元相圖
二、強度衰減的定量模型
相關文獻對引線框架上的熱壓鍵合進行了系統的溫度-時間研究。通過定期測試鍵合強度,建立了強度衰減與老化條件之間的定量關系:
活化能一致性:強度衰減速率符合Arrhenius動力學,表觀活化能與Cu-Au擴散活化能吻合,證實空洞擴散是主導機制;
失效判據與壽命:以鍵合強度降低40%為失效判據,預測100℃持續工作條件下壽命約為5年。若判據放寬至50%或60%,預期壽命相應延長;
氣氛影響:真空中老化的試樣強度保持率顯著高于空氣中老化的試樣,表明氧化環境加速界面損傷。
下圖給出了鍵合強度降低至初始值40%時,溫度與達到失效時間的關系曲線,該擬合結果為工程壽命預測提供了直接依據。
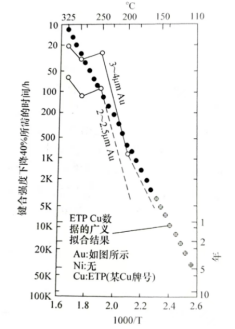
三、工藝因素影響
從力學檢測角度來看,Cu-Au鍵合強度受以下工藝參數影響較為顯著,不過鑒于Cu表面清潔工藝較為復雜,業界普遍采用連續點鍍Ag或薄Pd膜層作為工程優化方案。
工藝參數 | 影響 |
Cu層微觀結構與純度 | 細晶組織可能加速空洞形成,雜質元素作為空洞優先形核點 |
表面清潔度 | Cu表面氧化層阻礙金屬原子直接接觸,導致有效鍵合面積減小 |
氣氛控制 | 需使用中性或還原氣氛防止氧化,但成本相應增加 |
空洞無法在線監測,但其累積效應可通過力學測試精確表征,比如,可以通過鍵合強度測試來量化空洞導致的承載面積損失,通過斷口分析可以確定失效是否由空洞導致。通過多溫度點老化-測試組合,可擬合活化能參數,建立從工藝條件到服役壽命的量化映射。

科準測控自主研發的Alpha W260系列微電子推拉力試驗機,專為半導體封裝檢測設計:0.5級精度準確捕捉微米級鍵合點強度變化;支持剪切、拉力、疲勞等多種測試模式;配套軟件自動擬合強度衰減曲線,直接輸出壽命預測參數;可集成環境箱滿足多場耦合測試需求。從微觀空洞到宏觀數據,我們致力于為您提供可量化的力學檢測解決方案。如您對銅金鍵合體系有更多疑問,或對可靠性分析,推拉力試驗機產品等有任何想要了解的內容,請聯系我,工程師將竭誠為您服務。